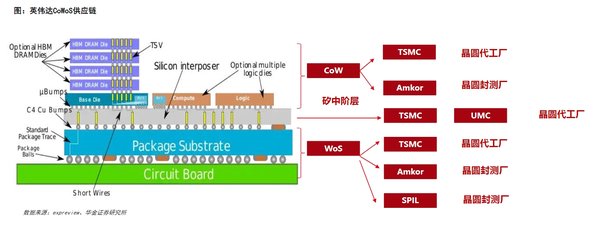
CoWoS封装技术:AI芯片的核心支撑
CoWoS(Chip-on-Wafer-on-Substrate)是台积电主导的先进封装技术,属于2.5D/3D集成方案。它通过高密度互连突破传统制程微缩的物理限制,显著提升芯片性能,成为AI芯片生产的关键技术之一。随着AI技术的快速发展,CoWoS封装技术的需求也持续攀升。

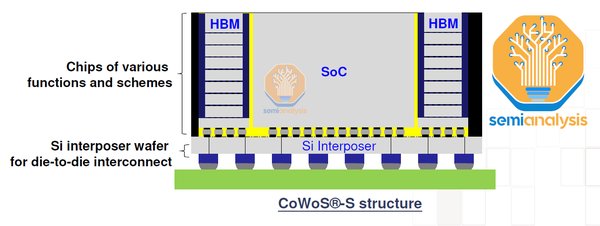
台积电与英伟达的合作动态
近期,市场传出英伟达削减台积电CoWoS封装订单的消息,引发广泛关注。然而,供应链和英伟达首席执行官黄仁勋均对此进行了澄清。黄仁勋表示,Blackwell系列芯片采用CoWoS-L封装技术,订单量的变化仅是技术升级的结果,而非需求下降。台积电的5/4纳米制程依旧满载,且Blackwell系列芯片的需求旺盛。
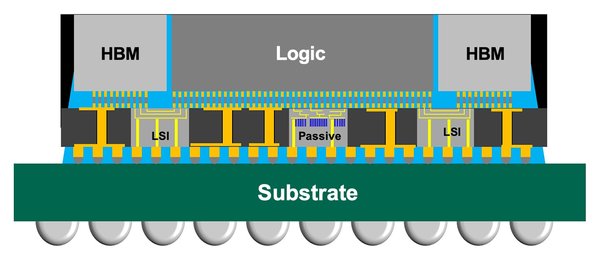

先进封装技术的挑战与机遇
CoWoS-L作为新一代封装技术,良率目前仅为70%至80%,远低于CoWoS-S的99%。这一技术挑战导致产能暂时受限,但台积电正积极扩产,预计2025年下半年全面转向新标准。此外,台积电通过收购群创南科厂等举措,进一步提升了CoWoS-L的产能,以满足客户需求。
Blackwell系列芯片的市场前景
Blackwell系列芯片的推出为市场注入了新的活力。供应链已收到GB300第一版规格,预计在GB200经验的基础上,导入速度将更快。Rubin GPU和Vera CPU的发展也进展顺利,预计明年初进入量产。这些新产品的推出将进一步推动AI芯片市场的增长。
结论
CoWoS封装技术作为AI芯片生产的核心技术,其发展动态对整个半导体行业具有重要影响。尽管短期内面临技术挑战,但台积电与英伟达的合作以及新产品的推出,预示着AI芯片市场的持续繁荣。未来,随着技术成熟和产能提升,CoWoS封装技术将在AI领域发挥更大的作用。
© 版权声明
文章版权归作者所有,未经允许请勿转载。
相关文章
暂无评论...
